財聯社4月19日訊(編輯 史正丞)一個月前剛剛宣布量產新一代HBM3E高帶寬存儲芯片的英偉達供應商SK海力士,現在又朝著下一代產品邁出嶄新征程。
當地時間周五,SK海力士與臺積電發布公告,宣布兩家公司就整合HBM和邏輯層先進封裝技術簽訂諒解備忘錄。雙方將合作開發第六代HBM產品(HBM4),預計在2026年投產。

背景:什么是高帶寬內存
眾所周知,高帶寬內存(High Bandwidth Memory)是為了解決傳統DDR內存的帶寬不足以應對高性能計算需求而開發。通過堆疊內存芯片和通過硅通孔(TSV)連接這些芯片,從而顯著提高內存帶寬。
SK海力士在2013年首次宣布HBM技術開發成功,后來被稱為HBM1的芯片通過AMD的Radeon R9 Fury顯卡首次登陸市場。
后續,HBM家族又先后迎來HBM2、HBM2E、HBM3和HBM3E。
SK海力士介紹稱,HBM3E帶來了10%的散熱改進,同時數據處理能力也達到每秒1.18TB的水平。
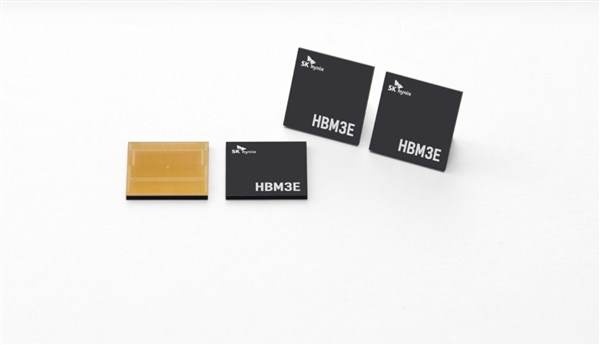
(HBM3E芯片成品,來源:SK海力士)
技術的迭代也帶來了參數的翻倍。舉例而言,根據英偉達官方的規格參數表,H100產品主要搭載的是80GB的HBM3,而使用HBM3E的H200產品,內存容量則達到幾乎翻倍的141GB。
找臺積電做些什么?
在此次合作前,所有的海力士HBM芯片都是基于公司自己的制程工藝,包括制造封裝內底層的基礎裸片,然后將多層DRAM裸片堆疊在基礎裸片上。

兩家公司在公告中表示,從HBM4產品開始,準備用臺積電的先進邏輯工藝來制造基礎裸片。通過超細微工藝增加更多的功能,公司可以生產在性能、功效等方面更滿足客戶需求的定制化HBM產品。
另外,雙方還計劃合作優化HBM產品和臺積電獨有的CoWoS技術融合(2.5D封裝)。
通過與臺積電的合作,SK海力士計劃于2026年開始大規模生產HBM4芯片。作為英偉達的主要供應商,海力士正在向AI龍頭提供HBM3芯片,今年開始交付HBM3E芯片。
對于臺積電而言,AI服務器也是在消費電子疲軟、汽車需求下降的當下,維持公司業績的強勁驅動因素。
臺積電預計2024財年的總資本支出大約在280-320億美元之間,約有10%投資于先進封裝能力。
三巨頭激戰HBM市場
根據公開市場能夠找得到的信息,目前國際大廠里只有SK海力士、美光科技和三星電子有能力生產與H100這類AI計算系統搭配的HBM芯片。而眼下,這三家正隔著太平洋展開激烈的競爭。
大概比SK海力士早大半個月,美光科技也在今年宣布開始量產HBM3E芯片。
今年2月,正在加緊擴展HBM產能的三星也發布了業界容量大的36GB HBM3E 12H芯片。英偉達上個月表示正在對三星的芯片進行資格認證,以用于AI服務器產品。
研究機構Trendforce估算,2024年的HBM市場里,SK海力士能夠占到52.5%的份額,三星和美光則占42.4%和5.1%。
另外,在動態隨機存取存儲器(DRAM)行業內,HBM的收入份額在2023年超過8%,預計在2024年能達到20%。
對于SK海力士與臺積電合作一事,普華永道高科技行業研究中心主任Allen Cheng認為是“明智的舉措”。
他表示:“臺積電幾乎擁有所有開發尖端AI芯片的關鍵客戶,進一步加深伙伴關系,意味著海力士能吸引更多的客戶使用該公司的HBM產品。”
本文鏈接:http://www.bbbearmall.com/news-128633.htmlSK海力士、臺積電宣布合作開發HBM4芯片 預期2026年投產























